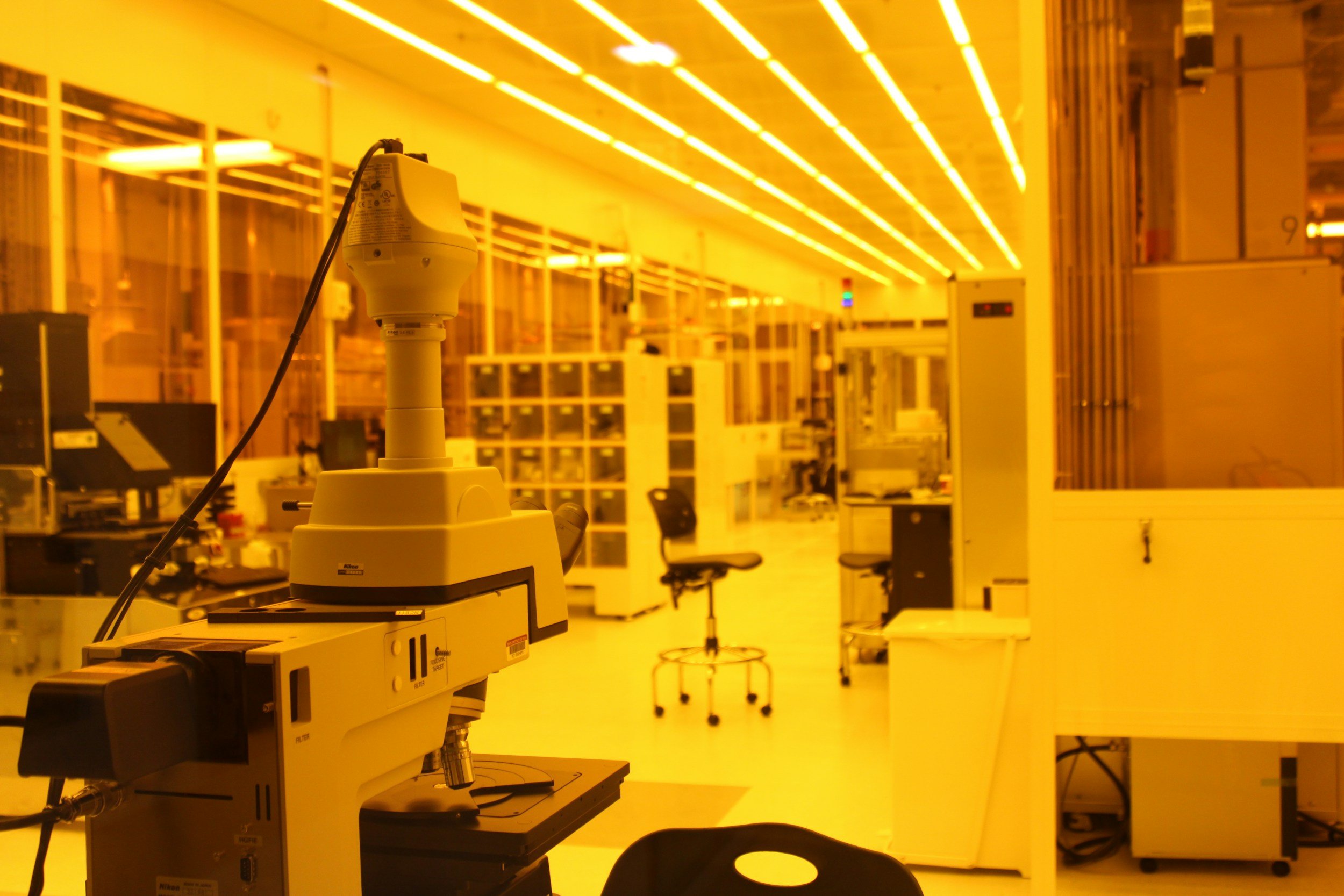
Reliability Tests
-

HTOL (HIGHT TEMPERATURE OPERATING LIFE)– VIDA ÚTIL A ALTA TEMPERATURA.
Esta prueba se utiliza para determinar los efectos de las condiciones de polarización y la temperatura en dispositivos de estado sólido a lo largo del tiempo. Simula el estado operativo de los dispositivos de forma acelerada.
-

LTOL – VIDA ÚTIL A BAJA TEMPERATURA
Esta prueba puede utilizar condiciones similares a las de la prueba de vida útil a alta temperatura, pero a temperaturas frías.
-

ELFR – TASA DE FALLAS EN LA VIDA TEMPRANA DE CIRCUITOS INTEGRADOS
Esta prueba proporciona características de fallas en etapas tempranas de la vida útil de tecnologías nuevas o no probadas cuando no hay datos genéricos disponibles.
-

RF HTOL (VIDA ÚTIL A ALTA TEMPERATURA A RADIO FRECUENCIA)
Esta prueba se utiliza para determinar los efectos de las condiciones de polarización de RF y la temperatura en módulos amplificadores de potencia (PAM), conmutadores, transceptores, sintonizadores y otros componentes de RF a lo largo del tiempo. Simula el estado operativo de los dispositivos de forma acelerada.
-

PTC – CICLOS DE TEMPERATURA Y POTENCIA
Esta prueba se realiza para determinar la capacidad de un dispositivo para soportar exposiciones alternas a temperaturas extremas altas y bajas con sesgos operativos aplicados y eliminados periódicamente.
-

THB – PRUEBA DE SESGO DE TEMPERATURA Y HUMEDAD
Esta norma establece un método y condiciones definidas para realizar una prueba de vida útil de temperatura y humedad con sesgo aplicado.
-

HAST – PRUEBA DE ESFUERZO ALTAMENTE ACELERADA
El propósito de este método de prueba es evaluar la confiabilidad de los dispositivos de estado sólido empaquetados no herméticos en ambientes húmedos.

